矽碁科技利用PEALD和PECVD各自镀膜的特点为用户开发了PECVD&PEALD联合镀膜系统,用于半导体工艺中的薄膜封装。ALD技术可以制备非常薄,非常致密的薄膜,但ALD技术制备致密薄膜需要的时间比较长,这在工业生产中是不能容忍的。为了克服ALD镀膜速度慢的劣势,将其与PECVD快速制备介质薄膜的技术集成到一起,可以实现多种不同材料交替堆叠的薄膜结构。实践证明,这种交替结构的薄膜封装性能可以达到与ALD技术同等的封装效果,同时降低了整个封装过程占用的时间。
ALD
1 不锈钢腔体,双层加热设计;
2 等离子体增强模块集成于腔体上盖;
3 进口高速ALD隔膜阀;
4 最大12英寸基片;
5 基片最高加热400℃;
6 最多可提供6路前驱物和6路工艺气体;
7 气路全金属密封,并可加热至120℃;
8 可提供前驱体钢瓶加热或冷却;
9 可全自动控制工艺过程,同时也可以手动操作。
PECVD
1 基片尺寸可定制;
2 低温工艺:< 150℃ / 350℃;
3 多层式工艺气体导入,气体分布均匀;
4 独立MFC控制箱,可灵活扩充工艺气路;
5 基片内镀膜均匀性优于 ±5%;
6 可与手套箱集成;

多层薄膜封装技术
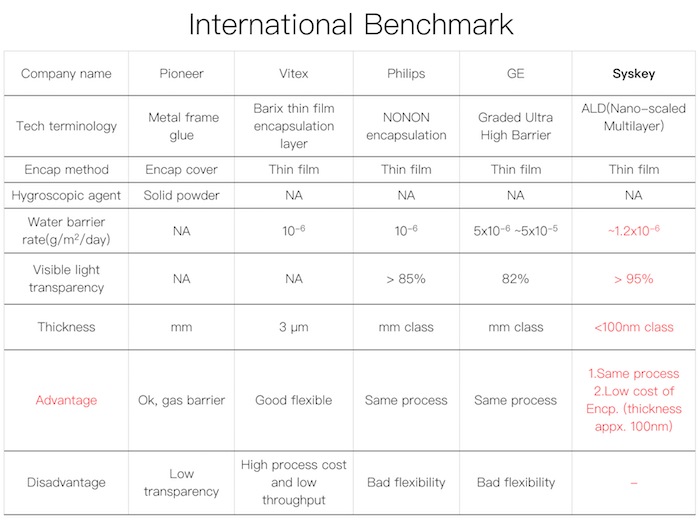
电话:0755-28485351
邮箱:info@hightrendtech.com
地址: 深圳市龙岗区坂田街道坂田社区坂雪岗大道3010号3层352室